SEMICON West 2014レポート: 450mm開発状況報告
SEMICONにて液浸リソグラフィーによる450mmパターンウエファーがお披露目
450mm全面パターンウエファーがはじめて、SEMICON West南ホールで現物展示され、また450mm技術開発セッションで紹介されました。これまでにも、2013年1月のSEMI ISS会議などで、全面パターンウエファーが紹介されたことはありますが、それはMolecular ImprintのImprio nanoimprint Lithography(NIL)装置で製作されたものでした。しかしながら、SEMICON Westの展示品はニコンの193nm液浸スキャナーによるものであり、300mmで現在使われている技術を使用したものとしては、初めての展示です。
|
|
SUNY CNSE/SUNYIT 副社長及びG450Cのゼネラルマネージャーであるポール・ファラー氏は「これらの最初の450mmウェーハは、この次世代技術に向けた業界の移行が、順 調かつ本格化していることの、明確な証拠である」と述べました。ニコンの液浸スキャナーは、2015年4月にAlbany NanoTech Complexの450mm設備に、プロジェクトの期限通りに加わる予定です。G450CメンバーとCNSEは、この重要なマイルストーンの達成により、 10nm以下の全面フォトグラフィーを実行が可能になり、また同時に、装置構成と性能の最適化もできるようになります。 (左写真: 193nm 液浸リソグラフィーによって全面パターニングされた最初のシリコンウェーハ) |
2013年7月に、3億5千万ドルの次世代リソグラフィー技術開発パートナーシップを締結したCNSE/SUNYITとニコンは、1年もかからずに初の液浸フォトリソグラフィー装置を提供したことになります。ニコンの馬立稔和(ウマタテトシカズ)氏は「ニコンはこの重要なマイルストーンを達成したことを大変嬉しく思っており、次の段階へのスタートに注力します。450mmスキャナーの開発は性能と生産性の革新を目指して進んでおり、Mooreの法則を継続するために求められるダイ当りコストの低減を実現します。」と述べました。 これまで3億5千万ドルを越える450mm装置がAlbany Nanotech Complexに納入されており、ここにニコンの液浸フォトリソグラフィー装置が到着すると総投資額は7億ドルを越えることになります。
450mmトランジションフォーラム
SEMIのAdvocacy担当グローバル副社長 Jonathan Davisは、450mmトランジションフォーラムの開会にあたり、講演者のDan Hutcheson氏 (VLSI Research)、Hamid Zarringhalam 氏(Nikon Precision)、 Paul Farrar氏、Frank Robertson氏、 Pinyen Lin氏 (G450C) を紹介しました。以下に各氏の講演のハイライトをまとめます。
450mmと「Mooreの壁」
VLSIリサーチ会長兼CEOのG. Dan Hutcheson氏は「450mmとMooreの壁」と題した講演で、450mmとスケーリングを、密接に関係してはいるが別のものだと捉える傾向について論じました。もしトランジスターの消費量が、(1970年以来のように)安定成長を続け、そしてもしスケールダウンが遅くなれば、シリコン面積の消費が増大するのは「単純な計算だ」とHutcheson氏は述べます。Mooreの法則が4年サイクルに延びると仮定するなら「大量のシリコンが必要となる」と彼は言いました。そして、さらに多くのファブを建設する必要が生じるでしょう。Mooreの法則が2年サイクルの場合は、2025年に1.4nmノードの量産が始まりますが、4年サイクルでは、設備投資が売上の30%を越えるようになり、急激に費用が増加し、事業継続が困難となります。

Hutcheson氏は「もし経済でないなら…Mooreの法則を支えるのは物理だ」と述べ、今すぐは必要とされない450mmだが、今後、その価値から利益を引き出すために必要となるだろうと続けました。
450mm技術開発に対するG450Cの見解
Global 450 Consortium (G450C)のPaul Farrar氏は「450mm 技術開発」について講演をしました。G450C Industry Interface and Program StrategyのゼネラルマネージャーであるFarrar氏は、ニューヨーク州アルバニーのナノスケール科学工科大学(CNSE)をベースに活動しています。
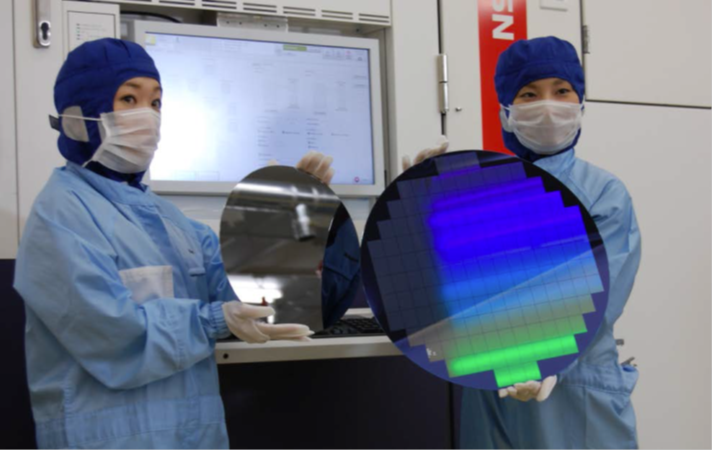
出所: G450C, 2014
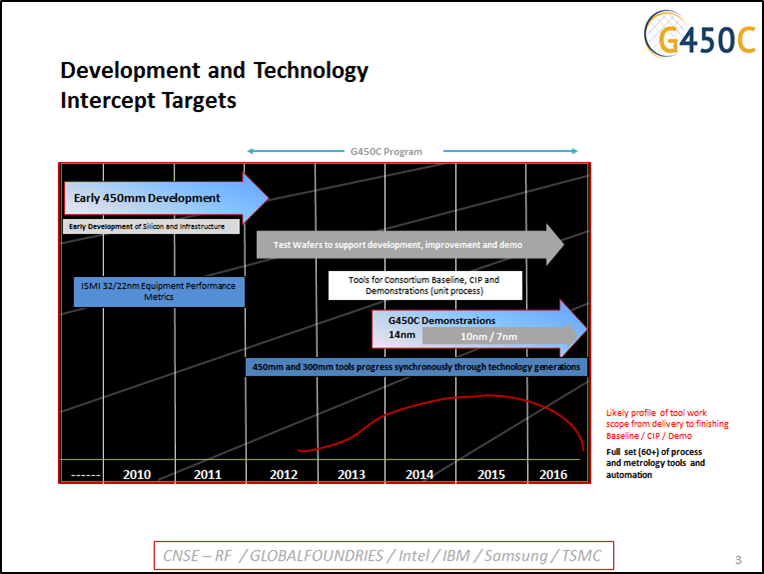
Farrar氏は、CNSEにおけるG450Cプログラムでは、参加する全サプライヤーが、装置の実証開発を継続していると述べました。このコンソーシアムは、約60のプロセス及び測定装置を、2016年までにそろえることを目指しています。Farrar氏は、プログラムの開始時に設定されていた14nm対応のターゲットに対し、現在はサブ10nmに向けて装置開発が行われていると続けました。
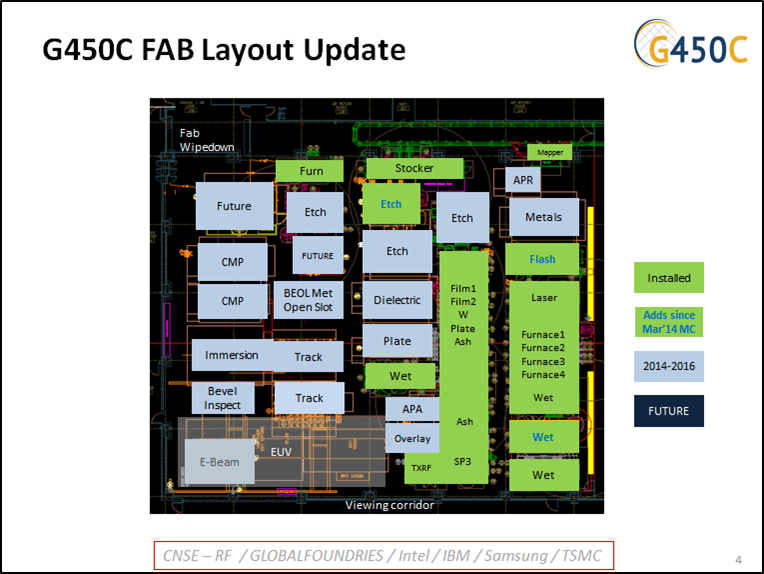
Farrar氏は装置の設置状況について、ステーションコントローラー(tMSP)を必要とする装置が29台がG450に設置されていると報告しました。また、ウェーハ在庫、ならびに薄膜装置の性能データについても報告がされました。G450は、装置開発および評価用に、11,500枚のウェーハを在庫しています。

450mmリソグラフィー開発アップデート:ニコンの見解
Nikon Precisionの執行副社長 Hamid Zarringhalam氏は、先端リソグラフィー開発について講演し、ウェーハ大口径化のモチベーションは、経済的にも、イノベーションの機会としても存在すると述べました。「450mmへのモチベーション」とは、30%のダイコスト削減という経済性であり、またイノベーションの豊富な機会でもあるとの主張です。さらに、300mmの知見から、移行を成功させるには業界全体の注力とマネジメントが必要とされること、開発投資をサプライチェーン全体で分担し最適化すること、300mmで起こったスタートの失敗を防ぐこと、業界としてタイミングを合わせることが、必須であると述べました。
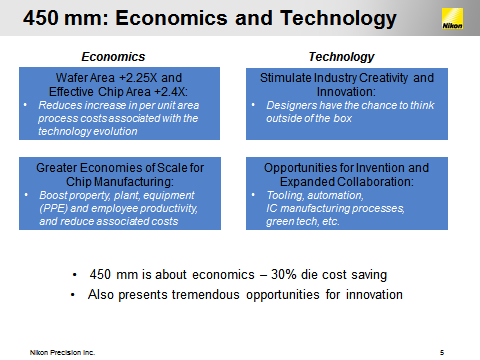
Zarringhalam氏は、450mm開発コストは約140億ドルに上り、その回収には長期間を要すると考えます。ボーイング787の例を挙げ、その開発費を完全に回収するには、22年間かかると予測されると述べました。業界成長率を3.8%とした場合、半導体業界の450mm移行はボーイング787のシナリオに類似すると主張し、そのため、業界は長期的視野に立つ必要があると彼は述べました。彼は、量産スタート時期についての合意と約束が最重要事項であり、「2010年代後半」を維持するために、早期になされるべきだと強調しました。リスクと報酬のバランスをとるためには、効率的なマネジメントが欠かせず、だからこそ、協力そしてG450Cが必要だと彼は感じています。
ArF液浸技術の延長による450mmリソ対応では、次のスケーリングとウェーハサイズ移行の要求を同時に満たす必要があります:
- 300mmを上回る生産性(m2/hr > 300mm)
- 生産性の利得より小さいコスト増
- フットプリントの最適化
- 積極的なスケーリングロードマップの要求に応える性能(オーバーレイ、イメージング、焦点、欠陥)
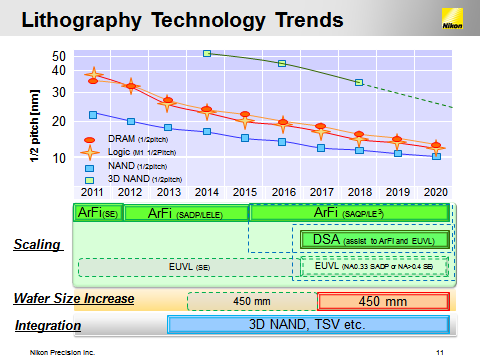
Zarringhalam氏によれば、液浸技術延長におけるニコンのイノベーションは、いかなるウェーハサイズにおいても、リソプロセスの要求を満たせるとのことです。450mmリソグラフィーからの利益は限られているという説もありますが、ニコンはそこに膨大なイノベーションの機会があると考えています。

ニコンの450mmプログラムは予定通り進んでいます。顧客からの受注をすでにしており、複数の装置が工場で製作中です。450mmのパターン付きウェーハは既にここにあります。G450C向け450mmパターニングサービスも、ニコン熊谷工場で予定通り始まっています。そしてニコンの450mm液浸スキャナーは、2015年4月に予定通りアルバニーに向けて出荷されるでしょう。
装置性能指標(EPM)の改訂
G450Cの副社長兼ゼネラルマネージャーであるFrank Robertson氏は、装置性能指標の改訂と装置実証のマイルストーンについて報告しました。業界全体にわたる調整、協力、そして標準化の成果をあげました。これには、European 450mm Equipment & Materials Initiative (EEMI450)との情報共有、Silicon SaxonyとのCMPスラリーリサイクル討議、Facilities 450 Consortium(F450C)とのEHS/施設に関する調整、SEMIの450mmスタンダードの標準化があります。

Robertson氏は「G450Cがサブ10nmの戦略を打ち出したことで、実証試験方法(DTM)モデルにも影響があるかという質問をお持ちの方もいるだろう。DTMの修正はまったくないという朗報をお伝えしたい。サブ10nmにおいてもDTMのベースライン部分にかける時間が、単純に当初の計画よりも長くなるだけだ。」と述べました。450DTMは、半導体ウェーハプロセス装置および測定装置のプロセス性能、信頼性の特性を、開発の各段階について示すガイドラインです。このガイドラインは、テストする装置やプロセスの開発の進捗度合いに応じた実験方法を提供します。
ノッチレス450mmウェーハへの業界移行
Pinyen Lin氏(G450C エッチング技術担当ディレクター、理学博士)もまた、450mm技術開発セッションで講演をしました。彼は、ノッチレスウェーハ標準化を推進し、方位表示基準マークをデザインする業界を横断するチームのリーダーです。講演では、2012年11月に装置サプライヤーから求められたノッチレスウェーハの評価、そして、SEMIのメンバーが示したノッチに関する諸問題(ストレス、非対称性、均一性、複雑な装置部品、エッジ除外領域)によって始まった、ノッチレス450mmウェーハのこれまでの進捗について、レビューがされました。G450Cによる、ワーキンググループの発足と、スケジュールの確定は、2013年2月のことでした。
2013年11月から2014年2月の第2段階のテストでは、3枚の異なるウェーハ上の9つの基準マークをテストし、リソ、測定、ハンドリング、プロセスの全ての装置の要求に対応する基準マークデザインのコンセプトが検証され、3つの基準マーク最終案が選ばれました。そして最終的な基準マークセットは、2014年3月に選定されました。2014年4月に開催されたSEMIスタンダードの北米地区会議において、バロットサイクル4での投票が承認され、投票の結果100%の賛成票が得られ、委員会承認がされました。SEMI M1の改訂は、SEMICON Europaにおける会議で通過する予定です。

出所: SEMI、G450C
次期ステップとして、Lin氏はノッチレスへの移行が2014年7月に始まると明言しました。G450Cでは新オリエンテーションマークを備えた450mmウェーハを準備します。装置サプライヤーによるノッチレスウェーハに向けた改造は、2015年初めから始まるでしょう。次に、少量ですが、2014年末には450mmピュアノッチレスウェーハが、装置開発用として提供できるようになります。装置サプライヤーは、その後も、他のSEMIスタンダード(座標システムの単純化, 1.5mmエッジ除外領域、SEMI M76など)への対応が必要となります。
次号のSEMI Global Updateにも450mm関連記事を掲載予定です。
本項に引用した講演資料、ならびに450mmに関する詳細な情報は、450Cemtral(www.semi.org/450)を参照ください。
(初出 SEMI Global Update 8月号)
