3D MEMS
資料來源:SEMI China / 秦文芳 (2010/07)
微機電 (MEMS) 技術在電子產品中的地位愈來愈重要,不論是在汽車、工業、醫療或軍事上都需要用到此類精密的元件,在訊息、通訊和消費性電子等大眾市場,也可以看到快速增長的MEMS應用。
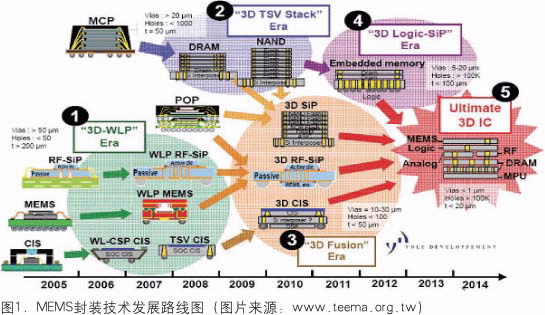
MEMS本質上是一種把微型機械零組件(如感測器、致動器等)與電子電路集成在同一顆晶片上的半導體技術。一般晶片只是利用了矽半導體的電氣特性,而 MEMS 則利用了晶片的電氣和機械兩種特性。
三維微電子機械系統(3D-MEMS),是將矽加工成三維結構,其封裝和觸點便於安裝和裝配,用這種技術製作的感測器具有極好的精度、極小的尺寸和極低的功耗。這種感測器僅由一小片矽就能製作出來,並能測量三個互相垂直方向的加速度。例如為承受強烈震動的加速度感測器和高分辨率的高度計提供合適的機械阻尼。這類感測器的功率消耗非常低,這使它們在電池驅動設備中具有不可比擬的優越性。
在 MEMS 感測器晶片內,三軸(X、Y、Z)上的運動或傾斜會引起活動矽結構的少量位移,造成活動和固定元器件之間的電容發生變化。在同一封裝上的接口晶片把微小的電容變化轉變成與運動成比例的校準模擬電壓。通常的模擬量採樣的方式有兩種:靜電電容式和壓電電阻式。前者在低功耗方面更具優勢,消耗電流更低。
MEMS與CMOS製程技術的整合,已成功帶動組件產品在消費電子應用綻放光芒,包括Intel、Samsung、TI、TSMC等半導體領導大廠皆看好CMOS MEMS發展,而相繼投入相關技術的研究開發。而CMOS MEMS組件能否進一步降低產品開發成本,3D MEMS封裝技術扮演了關鍵性的角色。
3D封裝技術除了可解決技術發展瓶頸,在異質整合特性下,也可進一步整合模擬RF、數字Logic、Memory、Sensor、混合訊號、MEMS等各種組件,且此整合性組件不但可縮短訊號傳輸距離、減少電力損耗,也能大幅增加訊號傳遞速度。此外,由於採取3D立體堆疊方式,故在Form Factor方面,也能在固定單位體積下達到最高的晶片容量。
隨著MEMS技術在消費電子應用的快速崛起,及半導體製造接近極限,透過TSV技術整合MEMS與CMOS製程,形成IC的3D化也逐漸受到矚目。由於3D MEMS隱含了異質整合特性,具備低成本、小尺寸、多功能、高效能等多重優勢,因此可望在未來掀起另一波技術應用革命,並為CMOS MEMS的發展帶來更大商機。
在看好相關產品技術發展前景下,業界已開始加速布局CMOS MEMS+3D MEMS Packaging解決方案。由於以TSV方式將Chip堆疊成3D IC的發展備受看好,也可望帶動3D TSV Wafer出貨數的快速成長,以組件類別來區分,目前以CIS(CMOS Image Sensor)採用TSV與IC 3D化的速度最快,第二階段預計將由內存(含Flash、SRAM、DRAM)扮演承接角色。3D MEMS可望在2011年興起,並在往後3年穩定邁向商品化。
MEMS產品大多以150mm~200mm的8寸晶圓生產,在未來6年有望逐步轉進300mm的12寸廠生產,以便做最佳化的產能利用。