CMP消耗品計量のためのSEMIスタンダードロードマップ
SEMI本部、Inna Skvortsova 2020年5月20日

SEMIは、2020年11月9日~11日にテキサス州オースティンで開催されるUltrapure Micro(UPM)カンファレンスで、最先端の半導体製造向けの初となるCMP(Chemical Mechanical Planarization)測定規格(一式)の発表を予定しています。
インテル、サムスン・オースティン・セミコンダクター、GLOBALFOUNDRIESなどの業界エキスパートによる共同チームの支援を受けて開催されるUPMは、半導体製造の高純度環境におけるマイクロコンタミネーション問題に焦点を当てた毎年恒例のイベントです。この会議は長年にわたり、超純水、超高性能化学物質、高純度ガスのほか、水管理や廃水処理などのトピックにも取り組んできました。
2020年のUPMプログラムでは、議論をウェーハに近づけ、先端ノードIC製造のための継続的なプロセス制御による歩留まり向上を可能にする業界全体の取り組みを支援しています。この議論は、サプライチェーンの様々なセクターにまたがる業界の専門家による緊密な連携を必要とする積極的な技術管理の中で行われます。次の図は、製造歩留まりを制約するコンタミネーションの問題を定義し、それに対処するために現在、業界で使用されているプロセスを説明しています。
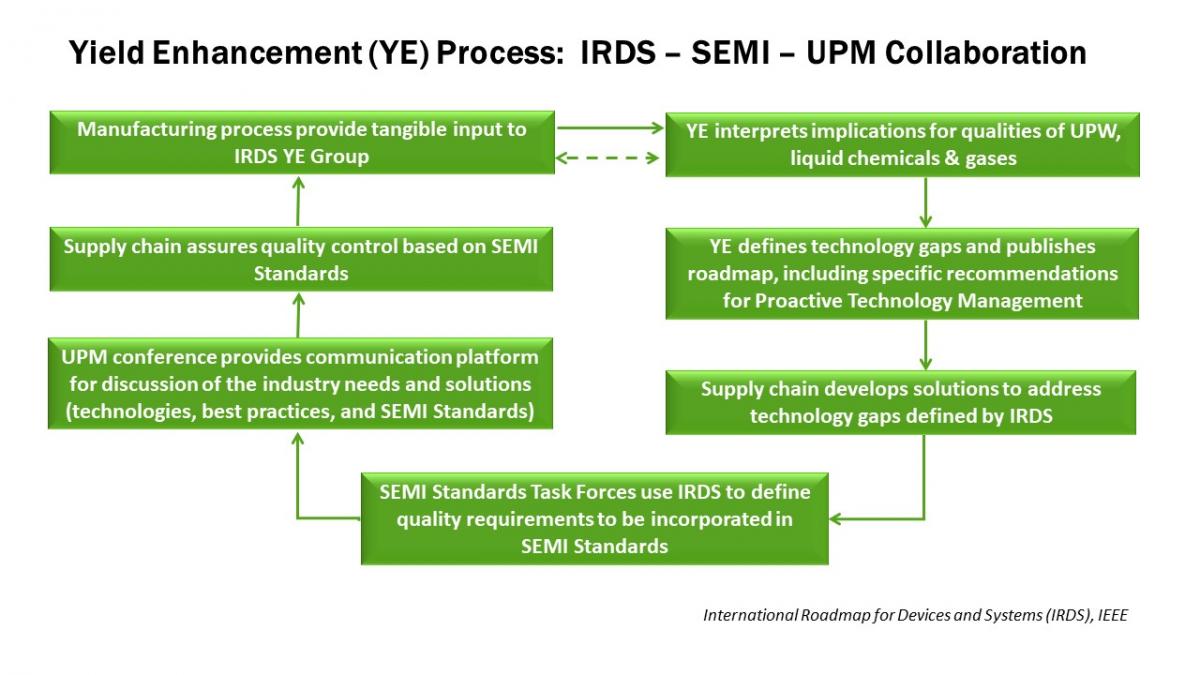
IC 製造における持続的な歩留まりを達成するための重要なプロセスモジュールの 1 つは、CMP (Chemical Mechanical Planarization) と CMP 後の洗浄です。この領域は、コントロールが最も困難な領域の1つでもあります。「CMPプロセスでの課題は非常にお金が掛かるプロセスであり、デバイスの歩留まりや信頼性にも大きな影響を与えることです。硬質材料(シリカ)と軟質材料(銅)を同時に研磨しながら、表面の傷を避け、腐食を防止し、最終的にはウェーハの均一性とグローバルな平面性を目標とするなど、複数の課題が要求されます」と、インテルの平面プロセスエンジニアであり、SEMIリキッドケミカル技術委員会北米支部の委員長を務めるDon Hadder氏は述べています。
変動を確実に検出して制御するためには、サプライチェーンのパラメータの標準化とCMPプロセスの標準化された測定法が必要不可欠です。
先端半導体デバイスの複雑化に伴い、垂直統合型デバイスメーカー(IDM)、CMP材料メーカー、CMP物流システムメーカー、計測機器メーカーなどの業界のエキスパートが協力して、CMP消耗品の計測に焦点を当てた初のSEMIスタンダードを開発しました(注1)。具体的には、密度、導電率、pH、微量金属、粒子数、研磨剤の粒度分布などの重要なCMPスラリーおよびCMP後の測定、およびCMP研磨パッドの硬さや密度などの測定を対象とし、さらに多くのパラメータを検討していきます(注2)。CMP消耗品測定のためのSEMIスタンダードロードマップは、UPM 2020カンファレンスの「高純度化学品セッション」で発表される予定です。
歩留まり向上は収益性の鍵となるため、この新しいSEMIスタンダードは、業界のサプライヤーとエンドユーザーの双方に不可欠なベンチマークを提供することで、業界に大きな影響を与えることが期待されています。CMPサプライヤーの仕様を一致させることにより、IDMはプロセスを適切に変更し、除去率を最適に制御し、ウェーハ表面での除去の一貫性を実現できます。
この記事に記載されているSEMI規格に関するご質問や、規格開発への参加をご希望の方は、Inna Skvortsova (iskvortsova@semi.org)までご連絡ください。
SEMIスタンダード開発活動は、年間を通じて、関連業界の主な生産地域にて行われています。SEMIスタンダード委員としてご参加いただくには、次のサイトにてSEMIスタンダード委員登録のお手続きを行ってください。www.semi.org/standardsmembership.
次のリキッドケミカル技術委員会北米支部会議は、北米地区2020年春季スタンダード会議期間中の3月31日に、カリフォルニア州ミルピタスにあるSEMI本部にて開催が予定されています。これらのスタンダード会議にご参加いただくには、SEMIスタンダードのプログラムメンバーでなければなりません。ご参加は無料ですが、プログラムメンバーとしてご登録いただく必要があります。
※3月31日に予定されていたリキッドケミカル技術委員会北米支部会議は、開催が延期されました。
注1:出版済みの文書
SEMI C98-1219: Guide for Chemical Mechanical Planarization (CMP) Particle Size Distribution (PSD) Measurement and Reporting used in Semiconductor Manufacturing
SEMI C99-0320: Test Method for Determining Conductivity of Chemical Mechanical Polish (CMP) Slurries and Related Chemicals
注2:開発中の文書
6489: New Standard: Guide for Reporting Chemical Mechanical Planarization (CMP) Polishing Pads Hardness used in Semiconductor Manufacturing
6646: New Standard: Guide for Reporting Density of the Chemical Mechanical Planarization (CMP) Pads used in Semiconductor Manufacturing
本件に関する日本国内でのお問合せ
SEMIジャパン スタンダード&EHS部
菅野博史 (hkanno@semi.org)
初出:2020年3月5日、Standards Watch, Volume 15, Issue 1
※本稿は、Standards Watchに掲載されました記事を日本語訳したものです。
元の記事 https://www.semi.org/en/standards-watch-2020Mar/roadmap-for-cmp-consumables-metrology