レガシィなパッケージ技術から三次元チップ実装技術、
さらにFan-out Wafer LevelやPLP技術への標準化活動の遍歴について
SEMIスタンダード3D Packaging & Integration日本地区技術委員会
共同委員長:釣屋政弘(iNEMI)、島本晴夫(AIST) 2018年3月23日
SEMI通信2018年2月号のSEMIスタンダード情報で述べたように、3D Packaging & Integration(3DP&I)グローバル技術委員会は、2つのグローバル技術委員会(Assembly & Packagingおよび3DS-IC)が2017年に統合されて以降、それぞれの傘下にあった各地区の活動が、各地区の垣根を超え、よりグローバルに展開しています。当3月号では、統合される前の各グローバル技術委員会が、どのようなSEMIスタンダード(規格)を開発および発行していたかを簡単に紹介します。
1.旧Assembly & Packagingグローバル技術委員会発行のSEMI規格
この技術委員会の設立当初は、日本地区をはじめ、北米地区やヨーロッパ地区でも活動が行われており、その各地区から数多くのSEMI規格が提案されてきました。しかし、北米地区やヨーロッパ地区での活動が次第に収束していき、この20年近くは、実質、日本地区だけで活動が行われてきました。2018年1月時点での旧Assembly & Packagingグローバル技術委員会発行のSEMI規格は、番号が「G」で始まるもの(GXX-MMYY)合計92件です。そのうち、統合後の3D Packaging & Integrationグローバル技術委員会にて引き続きサポートしているのは59件になっています。それらSEMI規格の内容は、リードフレームや封止材についての定義、材料特性や測定方法、メッキに関しては測定方法や組成規定、梱包材については挿間紙に関する特性やウェハのカセットやテープフレームおよびバーコードなどに関するものとなっています。これらは、SEMIスタンダード規約により、5年毎に内容を確認して、引き続き当該技術委員会がサポートを行うと判断した場合には、改訂や再承認のための作業を日本地区が中心となって行っています。図1は、旧Assembly & Packagingグローバル技術委員会にて発行された規格のトピックごとの内訳です。

図1:旧Assembly & Packagingグローバル技術委員会にて発行したSEMI規格の内容内訳
2.旧3DS-ICグローバル技術委員会発行のSEMI規格
2010年に3DS-ICグローバル技術委員会が発足し、まず北米地区で、続いて台湾地区でも活動が始まりました。日本地区では、準備段階として、2012年から旧Assembly & Packagingグローバル技術委員会日本地区傘下のStudy Group内にて議論が開始され、2015年に、3DS-ICグローバル技術委員会傘下に日本地区が設立され、ようやく、北米地区、台湾地区と並びました。3DS-ICグローバル技術委員会設立以降、統合後の現在までに、17のSEMI規格が開発及び発行されています。旧3DS-ICグローバル技術委員会発行のSEMI規格は、番号が「3D」(3DXX-MMYY)で始まります。
この3DS-ICグローバル技術委員会では、図2に示すように、3地区合わせて5つのタスクフォースを立ち上げました。北米、台湾及び日本地区のそれぞれの強みを生かしたSEMI規格の開発活動でした。その内訳は、3Dスタック用のウェハ材やガラス材の用語、特性や寸法、TVS (Through Via Silicon)に関する製造工程や測定方法などです。日本では特に2つの規格を策定しました。
- SEMI G96-1014: Test Method for Measurement of Chip (Die) Strength by Mean of Cantilever Bending
- SEMI G97-0116: Specification for Adhesive Tray Used for Thin Chip Handling
※これらのSEMI規格は、旧3DS-ICグローバル技術委員会日本地区設立前の旧Assembly & Packaging 技術委員会日本地区下で提案されたため、Gで始まる番号となっています。
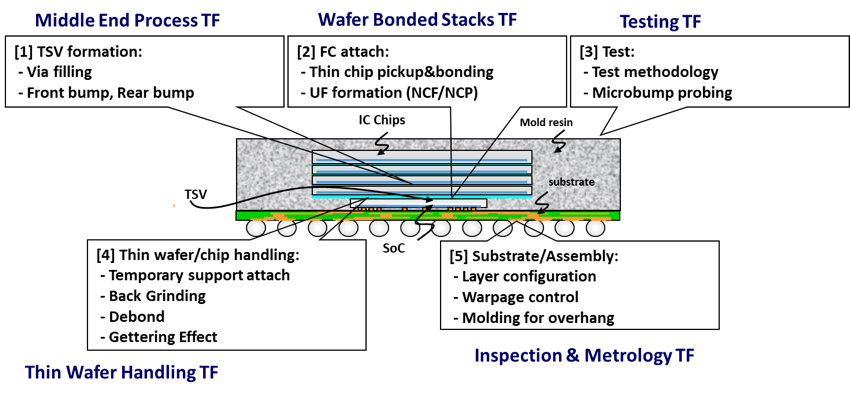
図2:旧3DS-IC グローバル技術委員会で活動したタスクフォース内訳
3.3D Packaging & Integrationグローバル技術委員会の活動の現状
3D Packaging & Integrationグローバル技術委員会では、その対象範囲をFan-Out Wafer Level PackageやPanel Level Packageに広げて標準化活動を推進しています。SEMI規格の開発が必要な分野については、日本地区では隔月でSteering Group会議を開催して議論しています。現在、グローバルで議論が進行中および計画中の規格案は、Panel Substrate Size For Fan-Out Panel Level Packaging (Document No. 6332)やThin Chip Micro-Crack Inspection Applicationsがあります。日本地区主導としては、Adhesion strength on molded surface Areaに関する検討(Document No. 5836)が始められており、当技術委員会活動紹介記事第三弾で、技術課題や標準化の必要性を論じながら、タスクフォースの活動プランを紹介する予定です。
当3D Packaging & Integrationグローバル技術委員会日本地区では、SEMI通信に継続的に活動状況を掲載し、より多くの⽅が本標準化活動へ参画されることを期待しています。
本件についての問合せ:
SEMIジャパン スタンダード&EHS部 柳澤智栄(cyanagisawa@semi.org )