2018年11月16日
FO-PLP Panel Level Packageの標準化活動・材料紹介
2018年11月号では、SEMIスタンダードで今最も活発な活動のひとつである3DのFan-Out Panel Level Packaging(FO-PLP)に関する2つのトピックについてご紹介いたします。ひとつはFO-PLPパネル用のFOUPの標準化活動で、日本・北米・台湾のユーザを含めた34社が議論している案件、もうひとつは今後標準化が見込まれるFO-PLP用の封止材料についてです。
1.Fan-Out Panel Level Packaging (FO-PLP) Panel FOUPの標準化活動の現在
PI&C(Physical Interfaces & Carriers)日本地区技術委員会
Fan-Out Panel Level Packaging (FO-PLP) Panel FOUPタスクフォースリーダー
アクティオンNEXT合同会社 小松省二
標準化の背景
複数のOSATや装置サプライヤより密閉型パネルFOUPの標準化の希望が寄せられています。OSATの要求仕様はそれぞれ異なっており、ドア開閉インターフェースや位置決め方法が全く異なるとオートメーションに関する開発コストが増大します。また、パネルFOUPは自身の重量、キャリアやパネルの重量も含め50kgを超える可能性もあり、搬送インターフェースの標準化も必要です。パネルサイズ等の標準化活動も開始されたことにより、パネルFOUP及び関連するインターフェースのSEMI標準化を目的として、Fan-Out Panel Level Packaging (FO-PLP) Panel FOUP Task Forceを設立し、2018年5月より開発をスタートしました。
基本コンセプト
FO-PLP用のパネルFOUPについては、既に開発が完了している450mmシリコンウェーハ用のSEMIスタンダード(E154:ロードポート、E158:FOUP)のドアインターフェース及び位置決めインターフェースを活用することで、標準化開発期間の短縮を図っています。図1に300 mm FOUP、450 mm FOUP、パネルFOUPの大きさの違いを示しています。また、図2にドアインターフェース活用のコンセプト図を示しています。高さ方向は変えずにパネル幅に合わせて幅方向のみを広げることを考えています。

図1: FOUPの外観図(大きさの比較)

図2: ドアインターフェース活用のコンセプト図
スタンダード文書開発スケジュール
表1にスタンダード文書開発予定表を示しています。当初の開発予定より1四半期延長し、2019年夏に、最終的なスタンダード文書案の承認を得ることを目指しています。そのプロセスの始まりとして、今年12月のSEMICON Japan 2018期間中に開催されるPI&C日本地区技術委員会会議において、パネルFOUP及びロードポートの2種類のスタンダード新規活動申請書(Standards New Activity Report Form)の承認を得る予定です。

表1 スタンダード文書開発予定表
注:表1では、黄色は、それぞれのアクションを行う期間で、赤のクロスは、その開催期間中に実施される技術委員会会議にて承認を得ることを示しています。
タスクフォース活動
このタスクフォースについては、現在、米国・日本・台湾よりユーザを含め34社60名が参加しており、WEB・電話会議を併用し月に1~2回のペースで開発を行っています。また、パネル仕様を開発しているFan-Out Panel Level Packaging (FO-PLP) Panel タスクフォースと常に情報交換を行っています。
SEMIスタンダード開発は開かれた活動であり、本タスクフォース活動に興味を持たれた方の参加を期待しています。
2.PLPに使われる封止材料の技術紹介と課題について
3D Packaging & Integration(3DP&I)日本地区技術委員会
共同委員長:釣屋政弘(iNEMI)、島本晴夫(AIST)
パナソニック株式会社 牧田 俊幸
今月号では、PLP用封止材料についても紹介します。SEMI通信 2018年7月号で紹介したように、PLP用の封止材料の形態としては、粉状、液状、フィルム(シート)状があり、粉状にはタブレット状と顆粒状があります。それぞれの形態に応じて封止プロセスも異なり、図1のように分類されます。
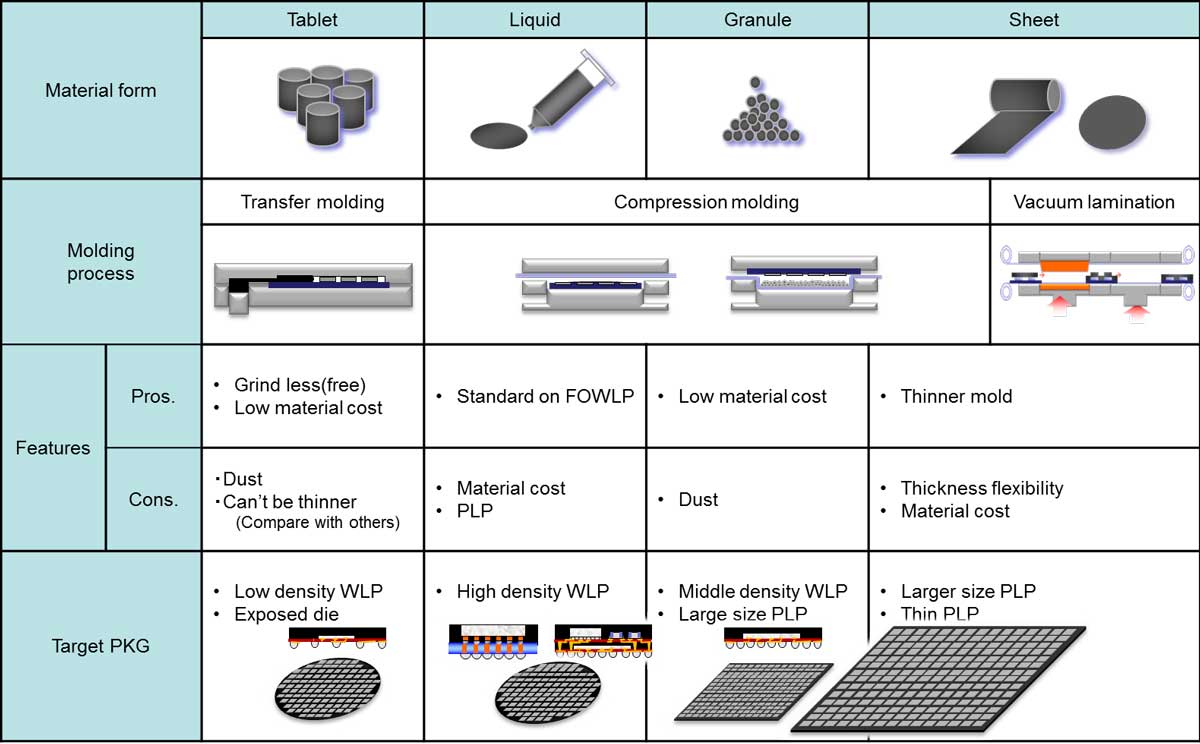
図1: FOWLP/PLPの封止材料、およびそのプロセス(出所:パナソニック株式会社資料)
それぞれのプロセスと対応材料についてそれぞれのメリット、デメリットを加えて紹介します。
材料単体でのコスト:
材料単体でのコスト比較をすると、一般的に粉状がもっとも低コストで、液状、フィルム(シート)状は比較的高くなります。
トランスファモールド:
トランスファモールドでは、タブレット状の封止材料を用います。エクスポーズドダイ構造を1ステップで形成することが可能である点がメリットですが、XY方向に樹脂を流動させることになるので、大面積での流動性を確保するのが難しく、また、注入圧力は位置依存で減衰が生じるため低圧化が難しいです。
コンプレッションモールド:
コンプレッションモールドは、顆粒状、液状、フィルム(シート)状の材料に対応することが可能です。このプロセスでは樹脂を送り出すトランスファモールドに比べて樹脂を流動させる距離が短くでき、注入圧力は位置に依存せず安定的です。
液状の封止材料:
WLPのeWLBやInFOにおいては、液状の封止材料を用いて採用されています。液状の材料は流動性の観点から、顆粒状、フィルム(シート)よりも有利ともいえます。しかしながら、eWLB、InFOのようにウェーハ形状において樹脂流動はコントロールしやすいですが、スクエア形状のPLPではコーナーへの充填性が難しくなります。また、液状とはいえ、一般的にはペースト状であるためワークサイズが大きくなるほど材料の供給性や充填性の効率は低下します。
顆粒状の封止材料:
PLPには顆粒状でのコンプレッションモールドが広く検討されています。顆粒状においてはワークサイズが大きくなってもそのような制限は現れにくいです。顆粒状での課題としては、発塵の問題があります。たとえばDie Firstであればモールド後にRDLプロセスを行うことになり、従来のパッケージングでは後工程だったモールドプロセスがPLPでは前工程のように高いクリーンレベルが求められることになります。そのような高いクリーン環境で行うには顆粒状の材料そのものがクリーンレベルを低下させるリスクがあります。封止材料としては顆粒サイズを工夫、コントロールすることで発塵の低減を図っています。
(※材料の形状に関係なく、封止プロセスそのものが発塵プロセスとして認識され、封止プロセスが隔離されていることも多いと考えられています。その意味では発塵の課題は顆粒状だけのものとは必ずしもいえません。)
フィルム(シート)状の封止材料:
フィルム(シート)状を用いるプロセスとしては、コンプレッションモールド、およびラミネートプロセスがあります。フィルム(シート)においても顆粒状でのコンプレッションモールドと同様にワークサイズが大きくなっても作業性に影響はありません。
フィルム(シート)状においては、特に薄型のモールドを行う場合に有利といえます。一方で、フィルム(シート)状で対応可能な厚みに制約があるため、それを超えるような厚物モールドにおいては1枚のフィルム材料ではなく複数枚を重ねて行うことになり、コスト、作業性に課題があるといえます。
また、フィルム(シート)状ではDieが間欠実装のパネルをフル実装の場合と同じモールド厚に制御できるかが課題になることが考えられます。たとえばDie Last工程において回路形成が出来なかった不適合な位置や、Die Last、Die First共通してロットエンドとしてDieの間欠実装がなされる場合、液状・顆粒状ではパネルごとの樹脂供給量の調整が容易ですがフィルム(シート)状の場合にはその調整が難しいです。
プロセスの自動化という点においてはフィルム(シート)をRoll to Rollで扱いたいところですが、材料ロスが多くなります。枚葉での取り扱いにおいてはプロセスの自動装置が複雑化することが考えられます。
封止材は、SEMICON Japan 2018展示会場内のSEMI Standardsブースに、実物を展示予定です。
3D Packaging & Integration技術委員会では、その標準化活動範囲をFan-Out Wafer Level Package(FO-PLP)やPanel Level Packageに広げています。SEMIスタンダードが必要と思われる分野について、日本では隔月でStudy Groupの会議を開催して議論しています。より多くの⽅に本標準化活動に興味を持っていただき、さらに参画されることを期待しています。
本件についての問合せ:
SEMIジャパン スタンダード&EHS部
柳澤 智栄(cyanagisawa@semi.org)
SEMIジャパンのメールマガジン「SEMI通信」
SEMI通信はSEMIジャパンから配信され、業界、市場、技術のトレンドをお伝えする記事と共に、SEMIの展示会、セミナー、スタンダード (標準化活動)、市場統計などの活動の最新情報を提供するメールマガジンです。
セミナーやイベント、市場統計の案内など半導体業界のホットな情報も併せてご覧いただけます。